Si/SiO2界面の構造と性質
半導体デバイスには必ず酸化膜(SiO2)が存在します。界面は電気特性や影響するため、Si/SiO2界面の構造を理解することは非常に重要です。ここでは、Si/SiO2界面の構造・性質について解説します。
なお、こちらの解説は先人たちの名著:半導体シリコン結晶工学を大いに参考にさせていただいております。興味がある方はぜひご参照してください。
Si/SiO2界面の構造
下図は、Si(100)面を[110]方向から観察した場合の、SiO2とSi界面の高分解能電子顕微鏡(HR-TEM)像です。
シリコン基板は結晶格子に起因する明瞭な原子像が得られているのに対し、SiO2はアモルファスで規則的な結晶格子は確認されません。
すなわち、Si/SiO2界面は結晶質→非晶質へと変化する、極めて急峻なヘテロ接合と考えられます。
SiとSiO2(熱酸化膜)の界面構造は、概ね下記の様に遷移すると考えられています。
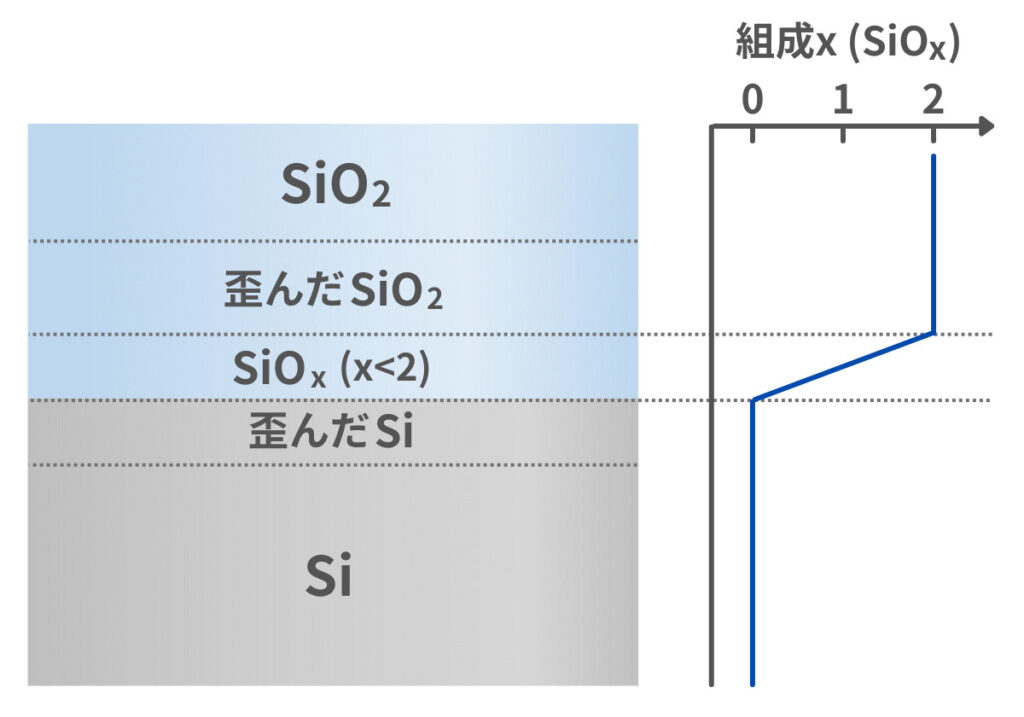
(出典:半導体シリコン結晶工学を基に筆者作成)
基板側から順番に、Si基板/歪んだSi/界面/SiOx/歪んだSiO2/SiO2という構造となっています。
酸化によるSi→SiO2の組成変化では、体積が約2.2倍に増加します。すなわち、界面近傍のSi基板には引っ張り応力が、界面近傍のSiO2には圧縮応力が掛かり、歪みます。
この界面近傍の応力を緩和するために、Si基板と酸化膜界面では、組成遷移領域としてSiO2から酸素が欠損したSiOxが形成されると考えられています。
一方で、組成遷移領域により歪を完全に除去することは難しく、酸化膜とSi基板、双方に応力・歪みが残留し、電気特性に影響を与えると考えられます。
ドーパントの再分布
シリコン基板中のドーパントは酸化膜成長熱処理と共に再分布します。
これは、Si中とSiO2のドーパントの固溶度と拡散速度(拡散係数)が異なるためです。Si中の不純物濃度を[C]Si、SiO2中の不純物濃度を[C]SiO2とすれば、平衡偏析係数mは次式で定義されます。
$$m = \frac{[C]_{Si}}{[C]_{SiO_2}}$$
m:Si-SiO2間の平衡偏析係数、 [C]Si:Si中の不純物の固溶度、 [C]SiO2:SiO2中の不純物の固溶度
Si/SiO2間の平衡偏析係数mは酸化雰囲気や熱処理条件、結晶面方位などで異なりますが、
- 偏析係数m<1:ホウ素(B)
- 偏析係数m>1:リン(P)、ヒ素(As)、ガリウム(Ga)
とされています。ドーパントの偏析は偏析係数mで表されますが、ドーパントの再分布はSi/SiO2間の拡散速度比、SiO2/Si界面の移動速度(=酸化速度)、ドーパント種によるSiO2中の拡散速度の相対比率などの要因によって決定されます。
下図は、偏析係数と、酸化膜中の不純物の拡散速度の組み合わせによる、Si/SiO2の濃度分布の分類表です。

(出典:半導体シリコン結晶工学および原著論文)
酸化膜形成前のドーパント分布は一定です(破線)。一方、
- 偏析係数m<1の場合
- 偏析係数m>1の場合
ドーパントはSiO2中に偏析します。拡散速度が小さい場合には、界面のSiO2側に高濃度にドーパントが蓄積されます。拡散係数が早い場合には、SiO2のドーパントはより低濃度・広範囲に分布します。
ドーパントはSi中に偏析します。拡散速度が小さい場合には、界面のSi側に、高濃度かつ急峻ににドーパントが蓄積されます。拡散係数が早い場合には、SiO2のドーパントはより低濃度・広範囲に分布します。
上記は一例であり、実際のドーパント再分布は基板方位・酸化雰囲気・熱処理条件などに依存します。
SiO2/Si界面近傍の酸化によるドーパント拡散・再分布は避けることが出来ないため、半導体デバイスの設計時には注意が必要です。
前の講座

次の講座










