Siウェハー表面の性質:親水性と疎水性
Siの自然酸化膜
シリコンウェハー表面には、10Å~30Å(1nm~3nm)の極めて薄い自然酸化膜が存在します。
Siウェハーの洗浄法でも述べた通り、半導体デバイスプロセスでは幾度となく洗浄が行われます。多くの場合、HFによる酸化膜除去が実施されます。
洗浄後のSi表面は極めて化学的反応性が高く、雰囲気中の水分や炭素と反応し、容易に酸化物や炭化物を形成します。従って、洗浄直後のSiウェハーを清浄に保つことは難しい課題です。
Siウェハー表面を清浄に保つためには、表面の化学的活性を低くする、言い換えれば、表面を安定化する必要があります。
HF洗浄後のSi表面
下図はHF洗浄+純水洗浄後のSi(100)面の模式図です。
HF洗浄+純水洗浄(リンス)後のSi表面は、H原子・F原子・OH基で終端されています。表面のダングリングボンドのほとんどはH原子で、一部がF原子・OH基で終端されています。
下図はHFによる酸化膜除去直後のSi表面のEELSスペクトルです。EELSとは試料に入射した電子のエネルギーロス量から、物質の結合状態や元素分析を行う手法です。
Si-Hに起因する吸収が確認され、洗浄直後のSi表面のダングリングボンドは水素原子で終端されていることが分かります。
また、以下はHFエッチングに続く、純水リンス前後のMIR-IR(中赤外分光法)スペクトルです。
純水リンス前はSi-F結合起因の吸収がある一方、洗浄後はSi-Hのみの吸収が確認されています。
すなわち、HF洗浄後直後はSi表面の一部はFで終端されていますが、その多くは純水洗浄によってH原子に置換されていると考えられます。
これは、F原子の電気陰性度が4.0と、H原子の2.2と比較して大きく、F原子と結合しているSiは正電荷に偏っている(δ+)ため、H2Oによる求核攻撃を受けやすいためと考えられています。
最後に、下図はHFエッチング+純水リンス後4時間経過後のMIR-IRスペクトルです。
純水リンス4時間後には、HFエッチング直後には観察されない、Si-O-Hに起因する吸収が確認されます。
すなわち、HFエッチング直後のSi表面はほとんどがH原子によって終端されますが、時間の経過と共に自然酸化膜が再成長しています。
以上をまとめると、HF+純水洗浄後のSiウェハー表面は、ほとんどがH原子で終端され、わずかにF原子や酸化膜によるOH基で終端されていると言えます。
親水性と疎水性
Siウェハー表面において、水に濡れやすい表面を親水性表面、水に濡れにくい表面を疎水性表面と呼びます。
下図はSiウェハー表面の濡れ性を表した模式図です。
Si表面の濡れやすさは、液体と固体表面が形成する接触角(θ)によって表されます。
- 完全に濡れる:θ=0°
- 不完全に濡れる:0°<θ<180°
- 全く濡れない:θ=180°
濡れの現象は、固体と液体それぞれの表面張力、及び固体/液体間の界面張力のバランスによって決まります(Youngの式)。
$$\gamma_{SG} = \gamma_{SL} + \gamma_{LG} \times \cos {\theta}$$
γSG:固体の表面張力、 γLG:液体の表面張力、 γSL:固体-液体間の界面張力
表面張力・界面張力とは、液体や固体がその表面を出来るだけ小さくしようとする性質のことです。物質の表面は構造の周期性が途切れる部分であり、Si表面ではダングリングボンドの形成などエネルギーが高くなります。物質がより安定状態となるように表面を減らす力が表面張力です。
- 固体の表面張力
- 液体の表面張力
- 固体-液体間の界面張力
固体表面が液体を引き込もうとする力です。固体表面の分子は、分子密度の小さい気体と接触しています。固体表面のエネルギーを最小化するためには、分子密度がより高い液体と接触する方が分子同士の相互作用が大きく有利であり、液体を引き込もうとする力が働きます。
液体が球面になろうとする力です。物質の表面積が最小となる形状は球体の為、液体には球体になろうとする力が働きます。
固体が液体を広げまいとする力です。固体表面分子と液体分子は相互作用しており、分子間の結合・相互作用により固体表面に液体が広がるのを引き留める力が働きます。
これら3つの力がYoungの式に基づいてバランスし、表面の濡れ性が決まります。
固体に関する表面エネルギーγSG, γSLは物質によって異なります。Si単結晶の場合、結晶方位や、表面原子のダングリングボンドを終端する原子・修飾基によって変化します。
すなわち、洗浄によるSiウェハー表面状態は濡れ性を決定する非常に重要なパラメーターと言えます。
Si表面の濡れ性
SiO2は親水性、Siは疎水性です。
Siウェハー上のSiO2はHF洗浄によって除去されるため、HF洗浄直後のウェハーは疎水性です。したがって、Siウェハーの濡れ性が親水性から疎水性に変わったことにより、表面酸化膜の除去を確認することが出来ます。
表面酸化膜が除去されたベアシリコンの疎水性表面は不純物やパーティクルに汚染されやすい為、洗浄後はSiウェハーの表面を親水性に保つことが重要です。
シリコンウェハー表面は、再表面のSi原子に結合する原子・(化学)基によって親水性にも疎水性にもなります。
下はSiウェハー表面の親水基・疎水基をまとめた表です。
| 名前 | 化学式 | |
|---|---|---|
| 親水基 | 水酸基 | -OH |
| カルボキシル基 | -COOH | |
| アミノ基 | -NH2 | |
| ケトン基 | =CO | |
| スルホ基 | -SO3H | |
| 疎水基 | アルキル基 | -CnH2n+1 |
| フェニル基 | -C6H5 |
水分子は酸素原子がプラスに(δ+)、水素原子がマイナス(δ-)に分極しています。Siウェハー表面に結合する基の分極が大きい(イオン性)場合、水分子によって水和されやすいため親水性になります。一方、基の分極が小さい場合は疎水性表面となります。
イオン性の親水基は水分子と水和で結びつき、非イオン性親水基は水分子と水素結合により結びつきます。ウェハー表面の親水性は-OH基またはSi-H結合を含むSi-[O3H]基に起因すると考えられています。
一方、疎水性表面は分極が弱く、水分子と結合を形成しにくいアルキル基やフェニル基等が結合しています。ウェハー表面の疎水性は主に、Si-H基とSi-CHxに起因すると考えられています。
シリコンウェーハ表面の親水性を保ち、表面汚染を小さくすることが安定した酸化膜を得るために重要であり、Siウェーハ表面を安定な-OH基で終端することが重要です。
前の講座
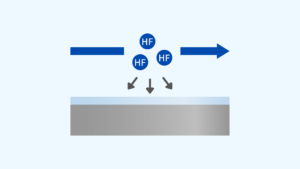
次の講座